
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
TaC Kaplı Grafit Parçaların Tek Kristal Fırınlarda Uygulanması
2024-07-05
UygulamaTaC Kaplamalı Grafit ParçalarTek Kristal Fırınlarında
BÖLÜM 1
SiC ve AlN tek kristallerinin fiziksel buhar taşıma (PVT) yöntemi kullanılarak büyütülmesinde pota, tohum tutucu ve kılavuz halka gibi önemli bileşenler hayati bir rol oynar. Şekil 2'de [1] gösterildiği gibi, PVT işlemi sırasında tohum kristali daha düşük sıcaklık bölgesinde konumlandırılırken, SiC ham maddesi daha yüksek sıcaklıklara (2400 ° C'nin üzerinde) maruz kalır. Bu, hammaddenin ayrışmasına ve SiXCy bileşiklerinin (öncelikle Si, SiC₂, Si₂C, vb. dahil) üretilmesine yol açar. Buhar fazındaki malzeme daha sonra yüksek sıcaklık bölgesinden düşük sıcaklık bölgesindeki tohum kristaline taşınır, bu da tohum çekirdeklerinin oluşmasına, kristal büyümesine ve tek kristallerin oluşmasına neden olur. Bu nedenle, bu proseste kullanılan pota, akış kılavuz halkası ve tohum kristal tutucusu gibi termal alan malzemelerinin, SiC ham maddelerini ve tek kristalleri kirletmeden yüksek sıcaklık direnci sergilemesi gerekir. Benzer şekilde, AlN kristal büyütmede kullanılan ısıtma elemanlarının Al buharı ve N₂ korozyonuna dayanıklı olması ve aynı zamanda kristal hazırlama süresini azaltmak için yüksek ötektik sıcaklığa (AlN ile) sahip olması gerekir.
SiC [2-5] ve AlN [2-3]'ün hazırlanması için TaC kaplı grafit termal alan malzemelerinin kullanılmasının, minimum karbon (oksijen, nitrojen) ve diğer yabancı maddeler içeren daha temiz ürünlerle sonuçlandığı gözlemlenmiştir. Bu malzemeler her bölgede daha az kenar kusuru ve daha düşük direnç sergiler. Ek olarak, mikro gözeneklerin ve aşındırma çukurlarının yoğunluğu (KOH aşındırma sonrasında) önemli ölçüde azaltılarak kristal kalitesinde önemli bir iyileşme sağlanır. Ayrıca, TaC potası neredeyse sıfır ağırlık kaybı gösterir, tahribatsız bir görünüm sağlar ve geri dönüştürülebilir (200 saate kadar kullanım ömrüyle), böylece tek kristal hazırlama işlemlerinin sürdürülebilirliği ve verimliliği artar.
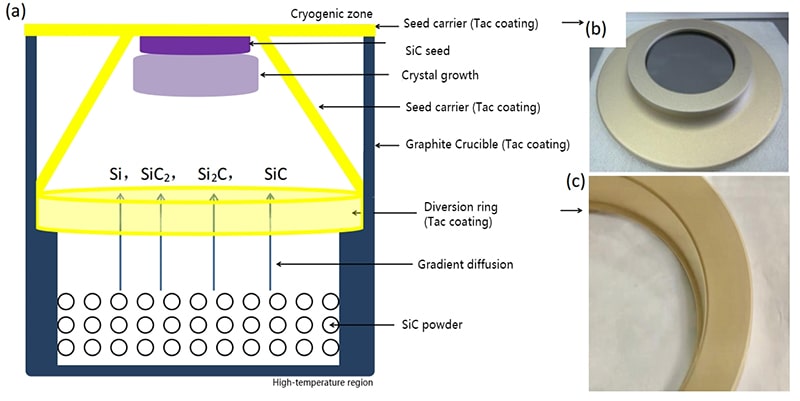
İNCİR. 2. (a) PVT yöntemiyle SiC tek kristal külçe yetiştirme cihazının şematik diyagramı
(b) Üst TaC kaplı tohum braketi (SiC tohumu dahil)
(c) TAC kaplı grafit kılavuz halkası
MOCVD GaN Epitaksiyel Katman Büyüme Isıtıcısı
BÖLÜM 2
Organometalik ayrışma reaksiyonları yoluyla ince filmlerin buhar epitaksiyel büyümesi için çok önemli bir teknik olan MOCVD (Metal-Organik Kimyasal Buhar Biriktirme) GaN büyütme alanında, ısıtıcı, reaksiyon odası içinde hassas sıcaklık kontrolü ve homojenliğin sağlanmasında hayati bir rol oynar. Şekil 3(a)'da gösterildiği gibi ısıtıcı, MOCVD ekipmanının temel bileşeni olarak kabul edilir. Alt tabakayı uzun süreler boyunca (tekrarlanan soğutma döngüleri dahil) hızlı ve eşit bir şekilde ısıtma, yüksek sıcaklıklara dayanma (gaz korozyonuna direnme) ve film saflığını koruma yeteneği, film biriktirme kalitesini, kalınlık tutarlılığını ve talaş performansını doğrudan etkiler.
MOCVD GaN büyütme sistemlerindeki ısıtıcıların performansını ve geri dönüşüm verimliliğini artırmak için TaC kaplı grafit ısıtıcıların piyasaya sürülmesi başarılı oldu. pBN (pirolitik bor nitrür) kaplamaları kullanan geleneksel ısıtıcıların aksine, TaC ısıtıcıları kullanılarak büyütülen GaN epitaksiyel katmanları neredeyse aynı kristal yapıları, kalınlık tekdüzeliğini, içsel kusur oluşumunu, safsızlık katkısını ve kirlenme seviyelerini sergiler. Üstelik TaC kaplama, düşük direnç ve düşük yüzey emisyonu sergileyerek ısıtıcı verimliliğinin ve homojenliğin artmasına neden olur, böylece güç tüketimini ve ısı kaybını azaltır. Proses parametrelerinin kontrol edilmesiyle kaplamanın gözenekliliği, ısıtıcının radyasyon özelliklerini daha da geliştirmek ve ömrünü uzatmak için ayarlanabilir [5]. Bu avantajlar, TaC kaplı grafit ısıtıcıların MOCVD GaN büyütme sistemleri için mükemmel bir seçim olmasını sağlar.
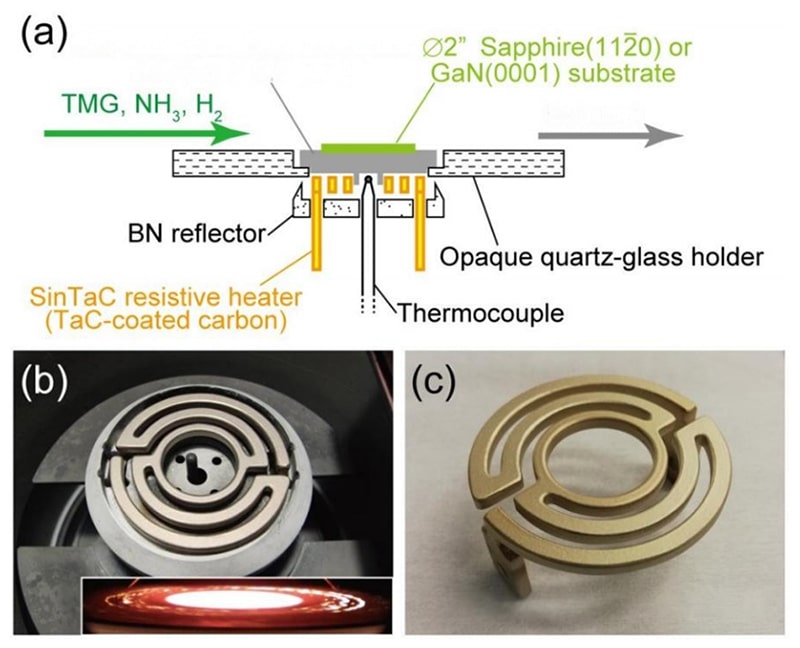
İNCİR. 3. (a) GaN epitaksiyel büyümesi için MOCVD cihazının şematik diyagramı
(b) MOCVD kurulumuna monte edilmiş kalıplanmış TAC kaplı grafit ısıtıcı, taban ve braket hariç (taban ve braketi ısıtmada gösteren çizim)
(c) 17 GaN epitaksiyel büyümeden sonra TAC kaplı grafit ısıtıcı.
Epitaksi için Kaplamalı Askı (Gofret Taşıyıcı)
BÖLÜM/3
SiC, AlN ve GaN gibi üçüncü sınıf yarı iletken levhaların hazırlanmasında kullanılan önemli bir yapısal bileşen olan levha taşıyıcısı, epitaksiyel levha büyüme süreçlerinde hayati bir rol oynar. Tipik olarak grafitten yapılan levha taşıyıcı, 1100 ila 1600 °C epitaksiyel sıcaklık aralığında proses gazlarından kaynaklanan korozyona karşı direnç göstermek için SiC ile kaplanır. Koruyucu kaplamanın korozyon direnci, levha taşıyıcının ömrünü önemli ölçüde etkiler. Deneysel sonuçlar, TaC'nin yüksek sıcaklıktaki amonyağa maruz kaldığında SiC'den yaklaşık 6 kat daha yavaş bir korozyon hızı sergilediğini göstermiştir. Yüksek sıcaklıktaki hidrojen ortamlarında TaC'nin korozyon hızı SiC'den 10 kat daha yavaştır.
Deneysel kanıtlar, TaC ile kaplanmış tepsilerin, safsızlıklara yol açmadan mavi ışık GaN MOCVD işleminde mükemmel uyumluluk sergilediğini göstermiştir. Sınırlı işlem ayarlamalarıyla, TaC taşıyıcıları kullanılarak büyütülen LED'ler, geleneksel SiC taşıyıcıları kullanılarak büyütülenlerle karşılaştırılabilir performans ve tekdüzelik göstermektedir. Sonuç olarak, TaC kaplı levha taşıyıcıların hizmet ömrü, kaplanmamış ve SiC kaplı grafit taşıyıcıların hizmet ömrünü aşmaktadır.
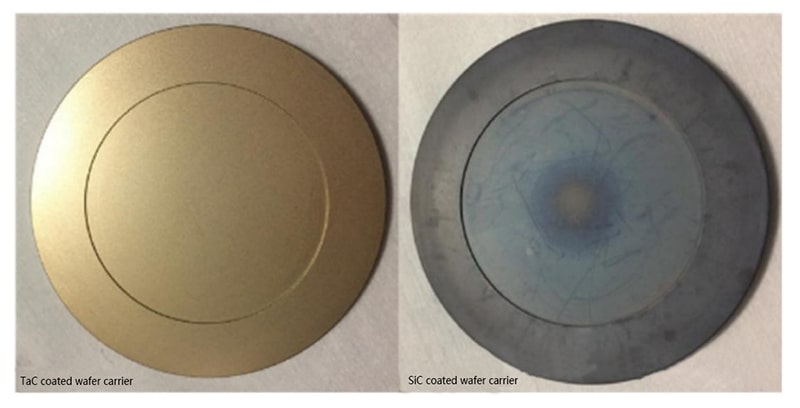
Figür. GaN epitaksiyel olarak büyütülmüş MOCVD cihazında (Veeco P75) kullanımdan sonra gofret tepsisi. Soldaki TaC ile, sağdaki ise SiC ile kaplanmıştır.
Ortak hazırlama yöntemiTaC kaplı grafit parçalar
BÖLÜM 1
CVD (Kimyasal Buhar Biriktirme) yöntemi:
900-2300°C'de, tantal ve karbon kaynağı olarak TaCl5 ve CnHm, indirgeyici atmosfer olarak H₂, taşıyıcı gaz olarak Ar₂, reaksiyon biriktirme filmi kullanılarak. Hazırlanan kaplama kompakt, tekdüze ve yüksek saflıktatır. Ancak karmaşık süreç, pahalı maliyet, zor hava akışı kontrolü ve düşük biriktirme verimliliği gibi bazı sorunlar vardır.
BÖLÜM 2
Bulamaç sinterleme yöntemi:
Karbon kaynağı, tantal kaynağı, dağıtıcı ve bağlayıcı içeren bulamaç grafit üzerine kaplanır ve kurutulduktan sonra yüksek sıcaklıkta sinterlenir. Hazırlanan kaplama düzenli yönlendirme olmadan büyür, maliyeti düşüktür ve büyük ölçekli üretime uygundur. Büyük grafit üzerinde tek biçimli ve tam kaplama elde etmek, destek kusurlarını ortadan kaldırmak ve kaplamanın bağlanma kuvvetini arttırmak için henüz keşfedilmemiş bir konu var.
BÖLÜM/3
Plazma püskürtme yöntemi:
TaC tozu, yüksek sıcaklıkta plazma arkı ile eritilir, yüksek hızlı jet ile yüksek sıcaklıktaki damlacıklara atomize edilir ve grafit malzemenin yüzeyine püskürtülür. Vakumsuz ortamda oksit tabakası oluşturmak kolaydır ve enerji tüketimi yüksektir.
TaC kaplı grafit parçaların çözülmesi gerekiyor
BÖLÜM 1
Bağlayıcı güç:
TaC ve karbon malzemeler arasındaki termal genleşme katsayısı ve diğer fiziksel özellikler farklıdır, kaplamanın bağlanma mukavemeti düşüktür, çatlaklardan, gözeneklerden ve termal gerilimden kaçınmak zordur ve kaplamanın çürüme ve çürüme içeren gerçek atmosferde soyulması kolaydır. tekrarlanan yükselme ve soğuma süreci.
BÖLÜM 2
Saflık:
TaC kaplamanın, yüksek sıcaklık koşulları altında yabancı maddeleri ve kirliliği önlemek için ultra yüksek saflıkta olması gerekir ve yüzeydeki ve tüm kaplamanın içindeki serbest karbon ve içsel yabancı maddelerin etkili içerik standartları ve karakterizasyon standartlarının üzerinde anlaşmaya varılması gerekir.
BÖLÜM/3
İstikrar:
Yüksek sıcaklık dayanımı ve 2300°C'nin üzerindeki kimyasal atmosfer direnci, kaplamanın stabilitesini test etmek için en önemli göstergelerdir. İğne delikleri, çatlaklar, eksik köşeler ve tek yönelimli tane sınırlarının aşındırıcı gazların grafite nüfuz etmesine ve nüfuz etmesine neden olması kolaydır, bu da kaplama korumasının başarısız olmasına neden olur.
BÖLÜM/4
Oksidasyon direnci:
TaC, 500°C'nin üzerinde olduğunda Ta2O5'e oksitlenmeye başlar ve sıcaklık ve oksijen konsantrasyonunun artmasıyla oksidasyon hızı keskin bir şekilde artar. Yüzey oksidasyonu tane sınırlarından ve küçük taneciklerden başlar ve yavaş yavaş sütunlu kristaller ve kırık kristaller oluşturur, bu da çok sayıda boşluk ve deliğin oluşmasına neden olur ve kaplama soyuluncaya kadar oksijen sızması yoğunlaşır. Ortaya çıkan oksit tabakasının termal iletkenliği zayıftır ve görünüm olarak çeşitli renklere sahiptir.
BÖLÜM/5
Tekdüzelik ve pürüzlülük:
Kaplama yüzeyinin eşit olmayan dağılımı, yerel termal stres konsantrasyonuna yol açarak çatlama ve dökülme riskini artırabilir. Ayrıca yüzey pürüzlülüğü, kaplama ile dış ortam arasındaki etkileşimi doğrudan etkiler ve çok yüksek pürüzlülük, kolayca levha ile sürtünmenin artmasına ve düzensiz termal alana yol açar.
BÖLÜM/6
Tane büyüklüğü:
Düzgün tane boyutu kaplamanın stabilitesine yardımcı olur. Tane boyutu küçükse, bağ sıkı değildir ve oksitlenmesi ve korozyona uğraması kolaydır, bu da tane kenarında çok sayıda çatlak ve deliğe neden olur ve bu da kaplamanın koruyucu performansını azaltır. Tane boyutu çok büyükse nispeten pürüzlüdür ve kaplamanın termal stres altında pul pul dökülmesi kolaydır.
Sonuç ve beklenti
Genel olarak,TaC kaplı grafit parçalarPiyasada büyük bir talep ve geniş bir uygulama yelpazesi mevcut olduğundan, mevcutTaC kaplı grafit parçalarana üretim yöntemi CVD TaC bileşenlerine güvenmektir. Ancak CVD TaC üretim ekipmanının yüksek maliyeti ve sınırlı biriktirme verimliliği nedeniyle geleneksel SiC kaplı grafit malzemeler tamamen değiştirilememiştir. Sinterleme yöntemi, hammadde maliyetini etkili bir şekilde azaltabilir ve daha farklı uygulama senaryolarının ihtiyaçlarını karşılamak için grafit parçaların karmaşık şekillerine uyum sağlayabilir.



